2023年 | プレスリリース・研究成果
結晶構造が異なるSiC同士のシームレスな積層に成功 ─パワー半導体の電力損失を大幅に削減できる見通しを得る─
【本学研究者情報】
〇電気通信研究所
准教授 櫻庭 政夫
教授 佐藤 茂雄
研究室ウェブサイト
〇未来科学技術共同研究センター
特任教授 長 康雄
研究室ウェブサイト
【発表のポイント】
- 同時横方向エピタキシャル成長法(注1)により、結晶構造が立方晶の3C-SiC(注2)結晶を六方晶の4H-SiC基板上に結晶格子をシームレスに(切れ目なく)積層させることに成功しました。
- SiCパワー半導体デバイスにおける電力損失低減と長期信頼性が両立できる新規デバイス構造(CHESS-MOS®)(注3)実現の見通しが得られました。
- SiCパワーMOSFETデバイスの電力損失の原因となる界面準位(注4)の密度が200分の1以下に低減されることを実証しました。
- 3C-SiC/4H-SiC/3C-SiC/4H-SiCのような二重量子井戸構造(注5)の形成が確認され、高周波デバイス・高周波集積回路の実現の可能性が示されました。
- 高温下や放射線にさらされる宇宙空間・原発廃炉作業場でも誤動作・故障が生じにくい長期信頼性に優れた集積回路の実現が期待されます。
【概要】
世界中で実用化が進められているSiCパワー半導体デバイスにおいて、SiCの物性に由来する根本的問題を克服する新技術の開発が望まれています。株式会社CUSIC(仙台市、代表取締役・長澤弘幸)が考案し権利化した新しいパワー半導体デバイス(CHESS-MOS®)はその有力候補で、異なる結晶構造・物性値を持つ3C-SiCと4H-SiCを積層させたハイブリッド構造基板によって実現されることが特徴です。
この度、東北大学電気通信研究所の櫻庭政夫准教授と佐藤茂雄教授、東北大学未来科学技術共同研究センターの長康雄特任教授、そして株式会社CUSICの研究グループは、共同研究を進める中で、3C-SiCと4H-SiCを積層させた ハイブリッド構造基板を同時横方向エピタキシャル成長法(SLE法; Simultaneous Lateral Epitaxy Method)を用いて製作することに世界で初めて成功しました。さらに、絶縁膜を形成したハイブリッド構造基板表面の界面準位密度を走査型非線形誘電率顕微鏡法(SNDM法; Scanning Nonlinear Dielectric Microscopy Method)(注6)によって計測した所、3C-SiC表面の密度を4H-SiC表面の200分の1以下まで大幅に低減できることを実証しました。これらのことから、SiCパワーMOSFETデバイスの長期信頼性が大幅に向上するのみならず、電力損失を30%以上削減でき、SiCパワー半導体デバイスを用いたシステムの高性能化・新機能創出と省エネルギー化の両立に大きく貢献できることが期待されます。
本研究成果は2023年9月18~22日にイタリアで開催された国際会議International Conference on Silicon Carbide and Related Materials(ICSCRM2023)と第84回応用物理秋季学術講演会(2023年9月19~22日、熊本)で発表されました。また、今後、国際会議MRS Fall Meeting & Exhibit(2023年11月26日~12月1日、アメリカ)でも発表される予定です。
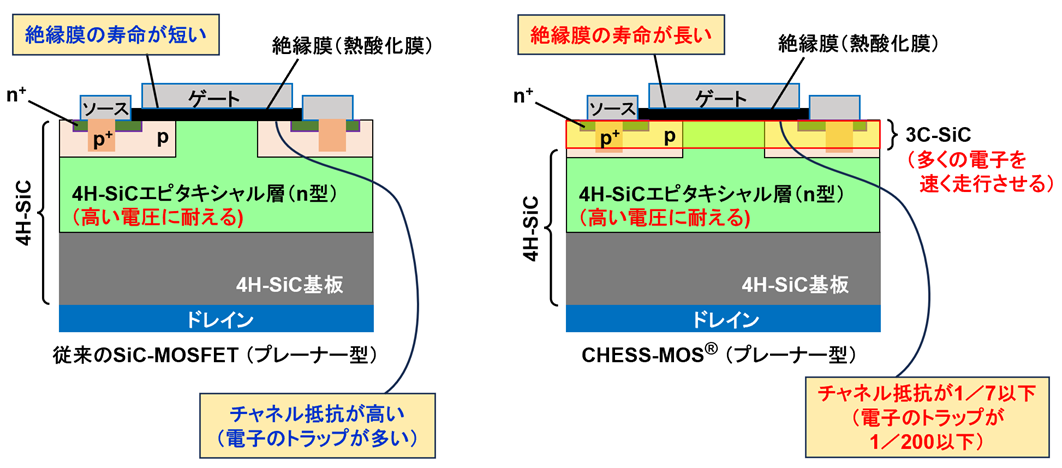
図1. SiCパワーMOSFETデバイスの断面図。(左)従来の4H-SiC基板を用いた場合、(右)4H-SiC基板にCHESS-MOS®を取り入れた場合。
【用語解説】
注1. エピタキシャル成長法:結晶基板の表面において、表面原子配列周期(原子間隔)を引き継ぎながら結晶が成長していくこと。成長方向の原子配列が同じとは限らない。SiCのエピタキシャル成長中に4H-SiC基板から延伸する4H-SiC基底面の上面に3C-SiCが結晶成長し、その3C-SiCもまた4H-SiC基底面に沿って延伸するような結晶成長方法を同時横方向エピタキシャル成長法(SLE法; Simultaneous Lateral Epitaxy Method)と呼ぶ。基底面を境界として、3C-SiCと4H-SiCが上下にくっきり分かれた積層構造が形成される。
注2. SiC(炭化珪素;シリコンカーバイド):シリコン (Si) と炭素 (C) の組成比1対1の共有結合性の化合物半導体結晶材料。Si(シリコン)単結晶と比較して、絶縁破壊電界強度は10倍、バンドギャップは2~3倍ほども大きいことから、高い電圧が掛かるパワー半導体デバイスに用いられる。化学組成は同じでも約200種類もの異なる原子配列の結晶構造(結晶多形、ポリタイプ)が見つかっている。代表的なものとして立方晶の3C-SiC、六方晶の4H-SiCと6H-SiCが知られている。
注3. CHESS-MOS®(Cubic and Hexagonal Epitaxially Stacked SiC MOSFET):エピタキシャル成長によって3C-SiCと4H-SiCを積層させた基板を用いて製作される金属-絶縁体-半導体電界効果トランジスタ(MOSFET; Metal-Oxide-Semiconductor Field-Effect Transistor)。特許第6795805号。
注4. 界面準位:絶縁膜と半導体の界面近傍に生じる準位であり、電子を捕獲したり、放出したりするもの。MOSFETの性能を低下させる原因と考えられている。
注5. 量子井戸構造:キャリア(電子やホール)が超薄膜中に閉じ込められ、キャリアの自由度が制限されているような構造。エネルギーバンド構造の異なる材料を接合させた界面近傍に生じることがある。通常の3 次元の自由度を持つバルク材料とは異なった新しい物性を発現する。
注6. 走査型非線形誘電率顕微鏡法(SNDM法; Scanning Nonlinear Dielectric Microscopy Method):走査型顕微鏡の探針を対象物質表面に近接させた状態で、物質内部の局所的な電荷の偏り(分極)を計測する方法。探針を2次元的に走査しながら計測することで、場所ごとの電荷の偏りやすさを二次元的に可視化(マッピング)することができる。
問い合わせ先
(研究に関すること)
東北大学電気通信研究所
准教授 櫻庭政夫
TEL: 022-217-5549
Email: sakuraba.masao*myad.jp(*を@に置き換えて下さい)
(報道に関すること)
東北大学電気通信研究所総務係
TEL: 022-217-5420
Email: riec-somu*grp.tohoku.ac.jp (*を@に置き換えて下さい)

![]()
![]()
東北大学は持続可能な開発目標(SDGs)を支援しています
